技術情報

FlabR(フラバー)はめっきの専門的技術と知識、経験があります。クライアントの事業にあわせた開発、改善のご提案ができます。
民生用コネクターや半導体コンタクトプロープのめっき開発で培った技術を有しています。
微細部品のめっき、新規開発や不具合対応の2つのシチュエーションを例に、FlabR(フラバー)がご提供できること、事例をご覧いただけます。

Technical Information 01 微細部品のめっき

近年のデバイスに搭載される部品はマイクロ化が進み、電⼦顕微鏡を使⽤しないと観察することができなくなりました。 微細な部品にめっきをすることで電気的特性および強度、耐⾷性、耐⾼温性などを付与することができます。
微細部品に使⽤される素材(材料)は特殊な合⾦材料が⽤いら れることが多くなり、めっきの難易度は⾼くなっています。 我々は世界最先端の電⼦部品に応⽤するために貴⾦属を使⽤ しためっきの研究・開発を得意とし、⼯法を含めて開発を⾏っています。
⼀般的に⾦属材料や樹脂材料の表⾯に銅やニッケルまたは貴⾦属である銀や⾦などのめっき加⼯を施し、装飾性はもちろん耐⾷性や電気伝導性を付加しています。
近年、電⼦機器は⼩型化と共に⾼機能化を伴い、そこに使⽤される電⼦部品は⾮常に微細化が進展しています。このような背景において、電子部品のめっきは単に耐食性や電気伝導性の機能だけでなく、高硬度や耐熱性または難めっき材へのハイスペックな機能要求が高まっています。
What we offer FlabR(フラバー)が出来ること
-
01
特殊かつあらたな付加価値
今までにない新たな付加価値や重複する特性を同時に取り込みたいといった難題に対し、お客様と共同で研究をおこなっています。特に半導体検査装置に使用されるコンタクトプローブの微細部品へのめっきを得意としています。
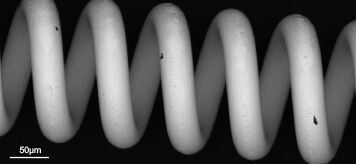
-
02
微細な穴を多数要した部品
微細な穴径は小さなもので直径約50μmであり、穴の内面を含め均一に機能性を付与しためっきをおこないます。
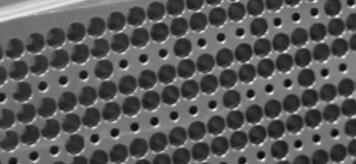
-
03
摩耗低減による耐久性向上
お互いが擦り合う部品同士の場合はトラボロジーを加味し、摩擦面の摩耗低減や摩耗粉の抑制など被膜の選定や細かな調整を行った被膜をつくりあげています。

Technical Information 02 開発品や不具合品の解析技術
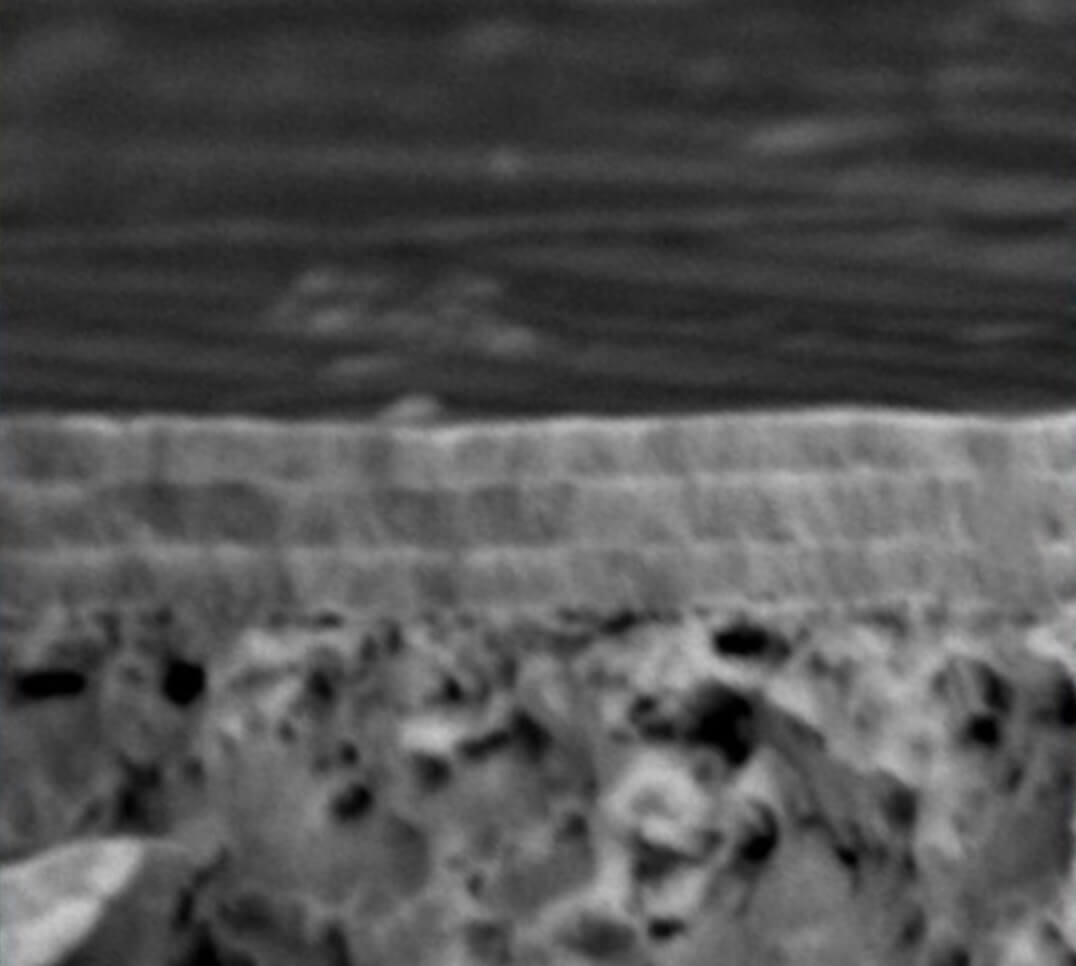
開発品をテストする過程において、様々な現象が発生します。その発生のメカニズムが解明されないと次のステップに進めません。そのために、現品を解析することは重要なポイントになります。
また、不具合発生時においても、メカニズム解明のために解析が必要となります。どの解析装置を使用し、どのような解析方法で行ったらよいのかを的確に判断する必要があります。解析の順序は重要な要素であり、誤るとメカニズム解明に繋がらないことになります。また、解析装置の選定と解析技術は開発時や不具合原因究明には重要なポイントになります。
What we offer FlabR(フラバー)が出来ること

-
01
走査型電子顕微鏡や走査型プローブ顕微鏡による観察
走査電子顕微鏡(SEM)は加速した電子線を試料に集束、移動させ表面形態を観察する装置。走査型プローブ顕微鏡(SPM) は微小なプローブで試料をなぞって、その形状や性質を観察する装置。原子・分子レベルの分解能を持つ。
-
02
蛍光X線膜厚計や高周波誘導結合プラズマを使用した解析
X線は電子が励起されたり、または電子が原子からはじき出された状態から安定な状態に戻る際のエネルギーをX線量で計測し膜厚計算する。高周波誘導結合プラズマ(ICP)は分析試料にプラズマエネルギーを成分元素(原子)を励起します。その励起された原子が低いエネルギー準位に戻るときに放出されるスペクトル線を測定する方法。
-
03
集束イオンビームやクロスセクションポリッシャによる断面からの解析
集束イオンビーム装置(FIB)は、イオンビームを試料表面で走査し、
試料表面を加工したりすることのできる装置です。
クロスセクションポリッシャ(CP)は、Ar+イオンビームと遮蔽(しゃへい)板を用いた断面試料作製装置です。
Example of usage 活用シーン
-

開発時の観察にSEMやSPM
コンタクトプローブを使用した電気検査では、プローブ先端が被検査物に直接接触して検査を行います。半導体検査では、ウェハー製造工程における前工程検査や後工程検査において使用されています。検査に使用されるコンタクトプローブは、正しい判定を維持できる耐久性も必要とされています。コンタクトプローブを構成する基材だけではこれらの要件を実現することが難しく、基材に表面処理を施すことで性能を確保しています。
コンタクトプローブを使用した接触検査では、検査時の接触圧力が低くても安定した結果を出力しなくてはならないため、プローブの被検査物への接触部は低抵抗でなくてはなりません。
また、コンタクトプローブを構成する各部品同士の接触部においても低抵抗化が必要です。更に、各部品は接触した状態で可動するため、摩擦摩耗の耐久性が必要となります。低抵抗であり、耐久性を両立させるために、特殊な表面処理技術が重要な要素となっています。
その他の課題として、大電流における耐久性、高温環境での使用における耐久性、高硬度材への接触に対する耐摩耗・変形、はんだバンプへの接触における耐久性、などがあります。これらの課題をめっきを含む金属材料で解決しています。
めっき皮膜を構成する結晶や結合力、皮膜特性をコントロールすることでコンタクトプローブのフォーマンスを最大化することができます。 -

不具合品解析時の調査にICP
コンタクトプローブのような微細部品で構成された製品の場合、製品使用中に発生した不具合の原因を追究することが非常に難しくなります。それは、原因追及に当たり、コンタクトプローブを構成する基材の種類や性質、熱処理に関する知識、めっき皮膜の性質、構成部品の加工方法、めっき加工方法、組立方法など、一連の技術的要素を理解していなければ不具合品を解析しても原因に辿り着くことはできません。
特に、めっきにおいてはちょっとした液の変動や電気的な変動が発生すると、めっき皮膜を構成する粒子に影響を与えてしまいます。そのため、皮膜の性質が変化し、製品としての性能が変わってしまいます。よって、不具合発生の現象に対して、めっき皮膜の状態や製造工法など多岐の要素を熟知した上での解析が必要となります。
現場改善とめっきのことならFlabR(フラバー)
お気軽にお問い合わせ・ご相談ください



 お問い合わせはこちら
お問い合わせはこちら
 FlabR(フラバー)について
FlabR(フラバー)について